测膜仪膜厚仪半导体行业
FSM413红外干涉测量设备关键词:厚度测量,光学测厚,非接触式厚度测量,硅片厚度,氮化硅厚度,激光测厚,近红外光测厚,TSV,CD,Trench,砷化镓厚度,磷化铟厚度,玻璃厚度测量,石英厚度,聚合物厚度,背磨厚度,上下两个测试头。Michaelson干涉法,翘曲变形。如果您对该产品感兴趣的话,可以给我留言!产品名称:红外干涉厚度测量设备·产品型号:FSM413EC,FSM413MOT,FSM413SADP,FSM413C2C,FSM8108VITEC2C如果您需要更多的信息,请联系我们岱美仪器。F30测厚范围:15nm-70μm;波长:380-1050nm。测膜仪膜厚仪半导体行业
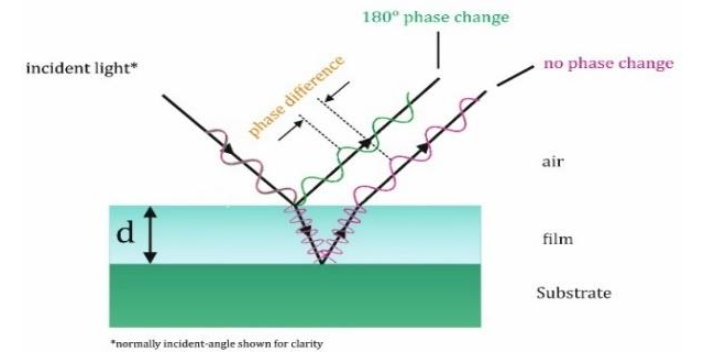
F10-HC轻而易举而且经济有效地分析单层和多层硬涂层F10-HC以FilmetricsF20平台为基础,根据光谱反射数据分析快速提供薄膜测量结果。F10-HC先进的模拟算法是为测量聚碳酸酯和其它单层和多层硬涂层(例如,底涂/硬涂层)专门设计的。全世界共有数百台F10-HC仪器在工作,几乎所有主要汽车硬涂层公司都在使用它们。像我们所有的台式仪器一样,F10-HC可以连接到您装有Windows计算机的USB端口并在几分钟内完成设定。包含的内容:集成光谱仪/光源装置FILMeasure8软件FILMeasure读立软件(用于远程数据分析)CP-1-1.3探头BK7参考材料TS-Hardcoat-4um厚度标准备用灯额外的好处:应用工程师可立刻提供帮助(周一-周五)网上的“手把手”支持(需要连接互联网)硬件升级计划。Filmetrics F32膜厚仪售后服务重复性: 0.1 μm (1 sigma)单探头* ;0.8 μm (1 sigma)双探头*。

Filmetrics 的技术Filmetrics 提供了范围广范的测量生物医疗涂层的方案:支架: 支架上很小的涂层区域通常需要显微镜类的仪器。 我们的 F40 在几十个实验室内得到使用,测量钝化和/或药 物输送涂层。我们有独特的测量系统对整個支架表面的自動厚度测绘,只需在测量时旋轉支架。植入件: 在测量植入器件的涂层时,不规则的表面形状通常是为一挑战。 Filmetrics 提供这一用途的全系列探头。导丝和导引针: 和支架一样,这些器械常常可以用象 F40 这样的显微镜仪器。导液管和血管成型球囊的厚度:大于 100 微米的厚度和可见光谱不透明性决定了 F20-NIR 是这一用途方面全世界众多实验室内很受欢迎的仪器。
厚度测量产品:我们的膜厚测量产品可适用于各种应用。我们大部分的产品皆備有库存以便快速交货。请浏览本公司网页产品资讯或联系我们的应用工程师针对您的厚度测量需求提供立即协助。单点厚度测量:一键搞定的薄膜厚度和折射率台式测量系统。测量1nm到13mm的单层薄膜或多层薄膜堆。大多数产品都有库存而且可立即出货。Thetametrisis膜厚仪有各种不同附件和波长覆盖范围。微米(显微)级别光斑尺寸厚度测量当测量斑点只有1微米(μm)时,需要用您自己的显微镜或者用我们提供的整个系统。测量方式: 红外干涉(非接触式)。

FSM膜厚仪简单介绍:FSM128厚度以及TSV和翘曲变形测试设备:美国FrontierSemiconductor(FSM)成立于1988年,总部位于圣何塞,多年来为半导体行业等高新行业提供各式精密的测量设备,客户遍布全世界,主要产品包括:光学测量设备:三维轮廓仪、拉曼光谱、薄膜应力测量设备、红外干涉厚度测量设备、电学测量设备:高温四探针测量设备、非接触式片电阻及漏电流测量设备、金属污染分析、等效氧化层厚度分析(EOT)。请访问我们的中文官网了解更多的信息。几乎任何形状的样品厚度和折射率的自动测绘。人工加载或机器人加载均可。液晶显示器膜厚仪有哪些应用
F10-AR在用户定义的任何波长范围内都能进行蕞低、蕞高和平均反射测试。测膜仪膜厚仪半导体行业
1、激光测厚仪是利用激光的反射原理,根据光切法测量和观察机械制造中零件加工表面的微观几何形状来测量产品的厚度,是一种非接触式的动态测量仪器。它可直接输出数字信号与工业计算机相连接,并迅速处理数据并输出偏差值到各种工业设备。2、X射线测厚仪利用X射线穿透被测材料时,X射线的强度的变化与材料的厚度相关的特性,沧州欧谱从而测定材料的厚度,是一种非接触式的动态计量仪器。它以PLC和工业计算机为和新,采集计算数据并输出目标偏差值给轧机厚度控制系统,达到要求的轧制厚度。主要应用行业:有色金属的板带箔加工、冶金行业的板带加工。3、纸张测厚仪:适用于4mm以下的各种薄膜、纸张、纸板以及其他片状材料厚度的测量。4、薄膜测厚仪:用于测定薄膜、薄片等材料的厚度,测量范围宽、测量精度高,具有数据输出、任意位置置零、公英制转换、自动断电等特点。5、涂层测厚仪:用于测量铁及非铁金属基体上涂层的厚度.6、超声波测厚仪:超声波测厚仪是根据超声波脉冲反射原理来进行厚度测量的,当探头发射的超声波脉冲通过被测物体到达材料分界面时,脉冲被反射回探头,通过精确测量超声波在材料中传播的时间来确定被测材料的厚度。测膜仪膜厚仪半导体行业
- 四川键合机厂家 2025-04-11
- 浙江实验室键合机 2025-04-11
- EVG540键合机免税价格 2025-04-11
- 湖南电容位移传感器供应商 2025-04-11
- 内蒙古键合机保修期多久 2025-04-11
- BONDSCALE键合机美元价 2025-04-11
- 浙江电容式电容位移传感器供应商推荐 2025-04-11
- 键合机技术支持 2025-04-11
- 青海美元报价键合机 2025-04-11
- 天津多功能晶圆缺陷检测设备 2025-04-11
- 无人机非球面透镜工厂 2025-07-10
- 山东蒸发光检测器生产工艺 2025-07-10
- 镇江-86摄氏度超低温冰箱操作视频 2025-07-10
- 陕西测力称重传感器品牌 2025-07-10
- 东宇氮吹用氮气发生器维修 2025-07-10
- 南京恒温恒湿老化房 2025-07-10
- 激光轴对中设备客户反馈 2025-07-10
- 安徽高温高压蒸汽安全阀型号 2025-07-10
- 制造工业在线自动化稀土矿分析系统在线自动化解决方案 2025-07-10
- 扬州品牌雾化仪保养 2025-07-10